Eesti teaduse teekaardi objekt NAMUR+
TOF-FIB-SIMS teenus
Tartu Ülikooli Keemia Instituut pakub võimalust kasutada Physical Electronics poolt toodetud fokusseeritud ioonkiir lõikamisvõimalusega lennuaja sekundaarioon massispektromeetri (FIB-TOF-SIMS) nanoTOF II uuringute teenuseid tahkete objektide pindade ning pinddefektide elementanalüüsiks. Ülimalt suur sügavustundlikus (paar aatom-/molekulkihti) võimaldab avastada ning tuvastada erinevate materjalide pinna saastumisi, mis on tihti asendamatu tööriist kvaliteedi kontrolli/vea tuvastamise protsessis. Lisaks võimaldab C60 ioonallika kasutamine tuvastada õhukeste orgaaniliste kihtide/kilede, sealhulgas kõikvõimalike polümeeride defekte ning ebakorrapärasid.

FIB-TOF-SIMS võimekus ei piirdu vaid aatomkihi analüüsiga kuna proove on võimalik tänu erinevatele ioonallikatele (5kV Ar+; 5kV O–; 30kV C60++) materjali pinda maha pihustada (Sputtering) ning koostada uuritavast objektist <nm lahutusega sügavusprofiil.
Makroskoopiliste objektide korral on võimalik teostada materjali keemilise koostise sügavusprofiili fokusseeritud ioonkiir lõikamise teel, kus Ga+ ioonkiirega lõigatakse objekti vaateava ning analüüsitakse kuni 200×200µm alaga ristlõiget. Järjestik lõikamise ja analüüsimise teel on võimalik rekonstrueerida materjali keemiline 3D struktuur.
Eritemperatuuridel mõõtmise jaoks on võimalik kasutada proovihoidjat, millega on võimalik kontrollida uuritava objekti temperatuuri vahemikus -150°C kuni 200°C. On võimalik ka kasutada kõrgtemperatuurset proovihoidjat, mille töövahemik on toatemperatuurist kuni 600°C.
Tänu TOF-SIMS suurele massilahutusele on võimalik eristada elementide erinevaid isotoope, mis võimaldab kasutada erinevate bioloogiliste ja ioonjuht materjalidel isotoop markeerimist näiteks deuteeriumi või 18-hapnikuga.
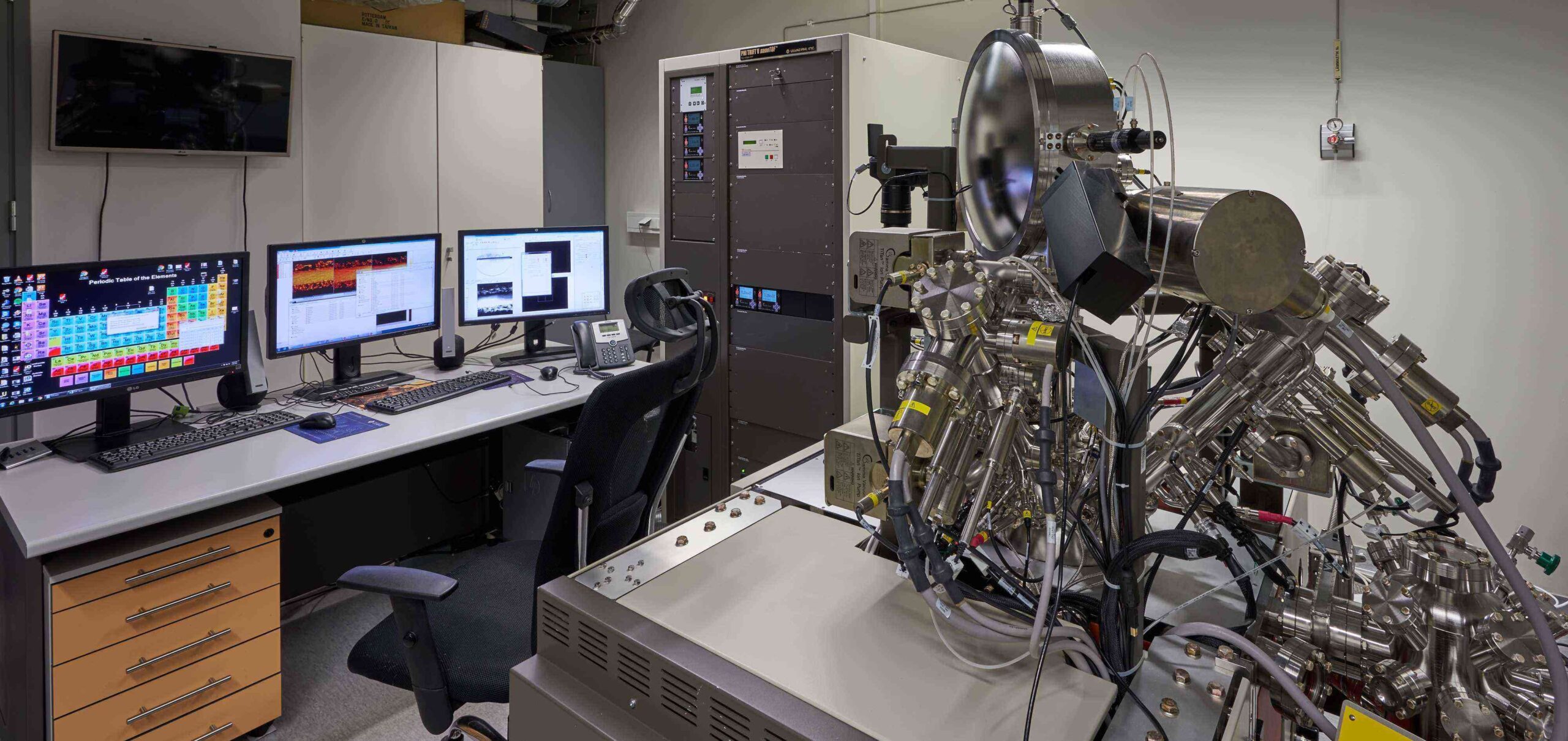
Teenused sisaldavad:
- spetsialisti(de) konsultatsioone: tellijaga arutatakse läbi nende teaduslik-tehnilised probleemid ja hinnatakse, kas antud metoodikad suudavad pakkuda tellijale huvipakkuvatele probleemidele lahendusi,
- proovide käitlemise koolitust,
- materjalide analüüsimist TOF-SIMS’ga kogenud operaatorite poolt,
- abi mõõtmistulemuste interpreteerimisel, vajadusel ka analüüsimisel,
- tellitud arendustegevusi, mille käigus töötatakse välja ja/või juurutatakse uusi uurimismeetodeid, mida antud taristu võimaldab rakendada tellija konkreetsete probleemide lahendamiseks,
- tellitud uurimistöid, kus labori spetsialistid koostöös tellijaga lahendavad tellijale huvipakkuvaid keerukamaid teaduslik-tehnilisi probleeme, mida pole võimalik lahendada mõne lühiajalise mõõtmise/analüüsi käigus – viimast kahte teenust saab/on mõistlik sageli ühitada.
Võimalik on korraldada insener-tehnilistele töötajatele lühiajalisi koolistusi materjalide karakteriseerimise meetodites.
- Kontaktisik: Enn Lust (e-mail: enn.lust@ut.ee)
- Operaatorid: Rait Kanarbik ja Priit Möller
Eesti teadustaristu teekaardi objekt „Nanomaterjalide tehnoloogiate ja uuringute keskus (NAMUR+)” on kaasrahastatud Euroopa Regionaalarengu Fondist (projektid „Nanomaterjalid – rakendused ja uuringud“, 3.2.0304.12-0397, 01.02.2012-31.12.2015 ja „Nanomaterjalide tehnoloogiate ja uuringute keskus”, 2014-2020.4.01.16-0123, 01.01.2017 – 30.06.2022 ) ning Eesti Teadusagentuuri poolt (projektid IUT20-54 ja TT13).


